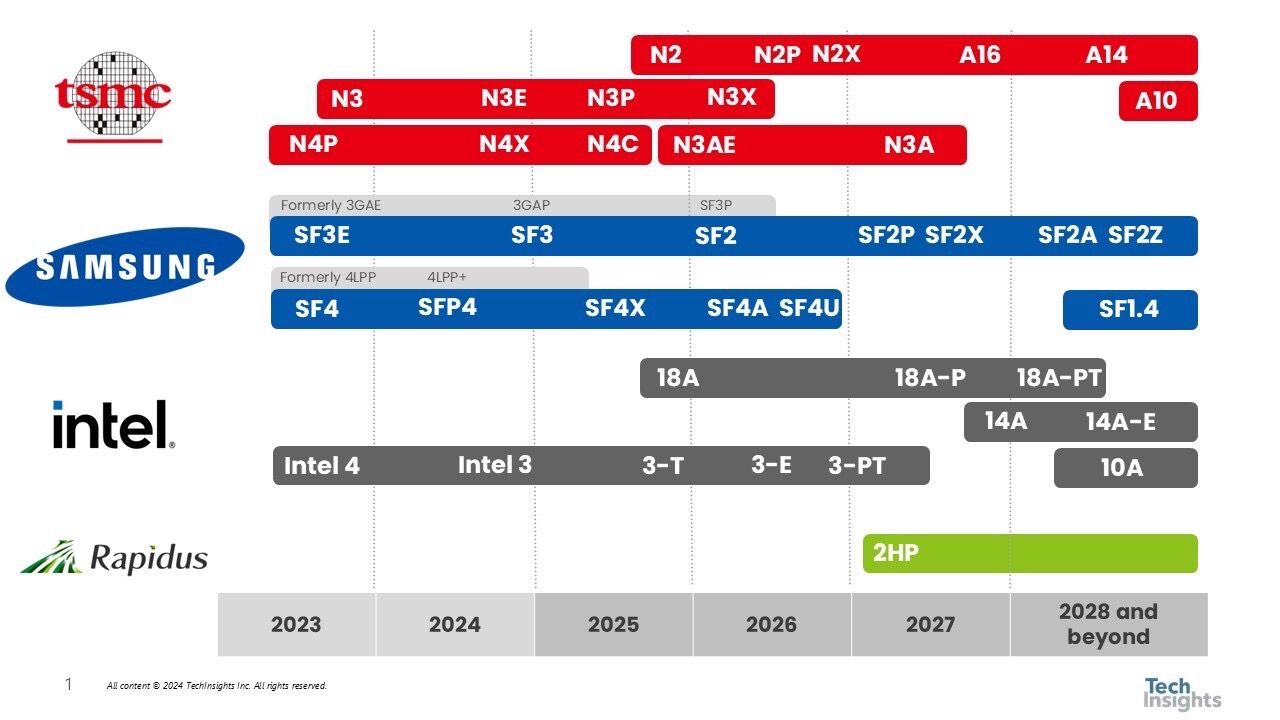


TechInsights對AI市場的五大趨勢預測:
AI 模型與資料中心趨勢
受「大型模型效能更佳」的信念驅動,大型語言模型(LLMs)的參數規模仍將持續成長。這意味著資料中心對於支援 LLM 的投資將在2026年持續增加,並推升整體 AI 能源成本,為獲利與環保目標帶來挑戰。AI 所需的電力遠高於傳統資料中心,大型園區的用電需求可高達 5GW,足以供應數百萬戶家庭,現有電網難以滿足這些需求,導致瓶頸產生。
不過,這種情況主要發生在全球少數開發「前沿模型」(Frontier Models)的公司身上。與此同時,體積更小、針對性更強或經「蒸餾(Distilled)」的模型將快速興起,並針對速度、效能、成本、隱私、文化與語言等需求進行最佳化。像是TechInsights 內部使用的語言模型Insightful Chat 基於公司半導體資料訓練,專為提供高隱私的專業分析而設計。
更小型、更專用的模型將用於特定任務,如構建 Agentic AI 的基礎,或讓Edge AI 能在有限硬體資源上運行。PC與NB處理器已經內建神經處理單元(NPU),但微軟的Copilot+ PC 並未成為市場預期的主導力量。
根據TechInsights 針對智慧家庭市場的研究顯示,雲端運算的依賴仍高於邊緣端,儘管邊緣推論在成本、功耗與隱私方面具優勢,雲端需求仍然強勁,預計「自律式邊緣運算」不太可能在 2026 年成為主流。
整體而言,儘管更專用、更高效的 AI 模型將持續發展,但市場仍將由多參數(Multi-Billion-Parameter)大型模型主導。這些模型的規模將進一步擴張,將記憶體與功耗推向極限。最終,在明年,真正的贏家將是能解決這些瓶頸的公司。
邁入2奈米製程:台積電、英特爾、三星、Rapidus四家競賽
邁向次世代 2 奈米製程,將同時改善功耗與效能。2026 年將是產業的關鍵轉折點,隨著業界從鰭式場效電晶體FinFET過渡到全閘極環繞GAA(Gate-All-Around)電晶體。這是自十多年前從平面電晶體轉向 FinFET 設計以來,電晶體架構的首次重大變革。
這項新架構可同時提升功耗效率與運算效能。台積電、英特爾、三星,以及新進者Rapidus 都將以 2 奈米製程進入市場。三星其實早在 2022 年便已在 3 奈米節點導入GAA 製程,但直到其 SF2版本的2奈米製程推出後,主要外部客戶才會真正採用該技術。
台積電的第一家2奈米(N2 製程)客戶是AMD,生產下一代EPYC 資料中心 CPU(非 GPU),並將於 2026 年推向市場。日本的 Rapidus 是晶圓代工領域全新的參與者,採用 GAA 製程技術,2023 年底開始建造第一座晶圓廠,目前傳出2奈米試產,預計量產供應外部客戶的時程預計要到 2027 年才會開始。
2026 年的 AI 加速器產品路線圖,將不會直接受到這些新製程的影響。例如,NVIDIA 的Rubin GPU 將使用台積電的 3 奈米製程生產,從 2027 年起,新一代 2 奈米架構才會開始改善 AI 加速器的效能與功耗表現。
高頻寬記憶體(HBM)幾乎專為 AI 加速器設計,是記憶體產業史上最具價值、毛利率最高的產品。記憶體廠商在推進 HBM3E 量產的同時,新一代搭載 16Hi HBM4的 AI 晶片預計將於 2026 年上半年實現量產,HBM 的基本晶片層(base die)也將從平面 CMOS改採更先進的 FinFET 製程,以進一步提升能效。
除了 HBM 之外,記憶體供應在 2026 年仍將偏緊,因為製造商預期會優先生產高毛利的DRAM 與 HBM,導致 NAND 產能受到擠壓,進一步加劇各類記憶體的價格波動。
儘管如此,NAND 技術仍在持續演進。3D NAND 的物理擴展主要由堆疊層數驅動。2026年,3xx 層(甚至更高層數)的 TLC 與 QLC 產品將陸續推出。為了實現更高密度與更佳效能,創新技術包括高長寬比蝕刻(High-Aspect-Ratio Cryogenic Etcher)、晶圓直接/混合鍵合(Hybrid/Direct Wafer Bonding),以及同層間間距控制(On-Pitch SGD, OPS)單元設計。
矽光子、散熱管理與先進封裝
記憶體晶片只是資料傳輸瓶頸的一半,另一半問題在於如何將資料從記憶體快速傳送至運算核心,速度與功耗是關鍵。以共同封裝光學CPO(Co-Packaged Optics)形式實現的矽光子技術,有望將網路功耗降低多達70%,同時提升資料傳輸速率,2026年將成為 CPO的關鍵轉折點。
台積電的「通用型光子引擎」COUPE(Compact Universal Photonic Engine)將被整合至晶片中介層封裝技術 CoWoS 2.5D 整合平台中,為產業領導者採用此技術鋪平道路,Nvidia的新一代交換解決方案也預計導入該平台。
隨著裝置的熱特性管理變得越來越重要,尤其在資料中心中更為嚴峻,因此最先進的 AI加速器如今必須依賴液冷(Liquid Cooling),導致資料中心建設成本上升,同時也帶來水資源短缺等環境挑戰。記憶體與CPO均對溫度極為敏感,因此當高密度記憶體元件更靠近運算核心,並與CPO 整合時,如何改善散熱管理,將成為能否導入新技術的關鍵環節。
先進封裝技術在此過程中扮演關鍵角色。業界正逐步採用玻璃基板(Glass Substrates),其優異的散熱性能與結構強度,有助於熱傳導與機械穩定性,同時,玻璃材料的高介電常數也能改善資料傳輸效能。其他方案包括開發更先進的熱介面材料TIMs(Thermal Interface Materials),例如SK海力士將在即將推出的 HBM4(16Hi)模組中採用先進的MR-MUF 封裝技術; 其他方向像是創新的製造技術,如英特爾的2奈米製程18A中採用的背面供電(Backside Power Delivery)結構,也能進一步提升晶片的熱性能表現。
貿易與關稅動盪
關稅與貿易限制正在造成高度波動的商業環境。許多地區正透過政府的大規模投資,推動半導體製造的自主化,美國同時也結合關稅與貿易限制作為額外手段,以促進本土製造,整個半導體產業形成一個充滿挑戰與不可預測的環境。
歷任美國政府採取的多項措施,目的皆在限制中國在半導體領域的進展。作為回應,中國正加速推動其 xPU(包含 CPU、GPU、NPU 及其他處理器)的研發,並朝向作業系統自主化發展,特別是透過 RISC-V 架構。
由於極紫外光EUV曝光設備受限,中國的邏輯晶片製程仍停留在7奈米製程節點,遠落後於全球邁向2奈米前沿製程的腳步。2026 年中國能否推進自身的半導體設備生態系? 最有可能的結果是,中國政策將持續支持並發展國產替代方案,同時允許在本地技術尚未成熟之前,持續使用外國設備。中國在顯影設備技術上的進展,將成為2026年值得密切觀察的關鍵領域。
中國的AI模型發展
中國在AI模型領域已大致追上國際水準,在AI研究論文數量、專利申請與創投投資方面均位居全球前列。國產大型語言模型如 DeepSeek R1在效能上已可與美國頂尖的封閉式模型相媲美,同時通常具有更高的成本效益,並多以開源形式發布。雖然相關限制在一定程度上限制了中國獲取先進硬體的能力,但預期 2026 年將會出現更多來自中國的軟體創新。
